TOF-SIMS在聚合物薄膜和涂層的光譜分析
飛行時間二次離子質譜( Time of Flight Secondary Ion Mass Spectrometry ,TOF-SIMS)是通過高能量的一次離子束轟擊樣品表面,使樣品表面的原子或原子團吸收能量而從表面發生濺射產生二次粒子,這些帶電粒子經過質量分析器后就可以得到關于樣品表面信息的圖譜。
SIMS用于在超高真空條件下分析固體樣品中元素、分子和同位素的分布和相對濃度,是最靈敏的表面分析技術之一。SIMS可用于成像、光譜分析和深度剖面/三維分析。
光譜分析模式可用于評估聚合物涂層的組成及其橫向均勻性,同時能夠檢測和量化聚合物表面功能基團的密度。作為一種簡便而強大的技術,光譜分析在表征通過表面反應制備的聚合物涂層方面具有重要應用,例如聚合物刷和等離子體聚合膜。聚合物刷通常用于調節基底的化學性質,并通過接枝或去除反應進行制備。光譜分析可以通過評估不同蝕刻深度下刷子的成分來探測其結構,這對于表征塊狀共聚物刷子的有序性具有重要意義。此外,表面光譜分析還可以通過繪制表面成分圖來檢驗樣品內部及不同樣品之間的組成均勻性。這些數據可以為移植物的供體或受體移植方案的發展提供信息。例如,Schulz等人通過表面引發原子轉移自由基聚合(SI-ATRP)技術,將超薄聚(N-異丙基丙烯酰胺)(PNIPAAM)刷子成功轉移至硅基底上。光譜分析結果證實,每個樣品的表面均成功生長出薄PNIPAAM刷子,并且在激活劑/抑制劑([Cu(II)]0/[Cu(I)]0)比率范圍內,刷子的化學組成保持一致。等離子體聚合是一種常用的技術,用于在基底上制備薄而機械強度高的膜層。光譜分析能夠確定等離子體聚合涂層是否與商業可獲得的聚合物(即溶液中合成的聚合物)具有相同的化學性質。例如,Oran等人的研究表明,等離子體聚合聚(烯丙胺)涂層的化學性質依賴于所采用的等離子體條件,與商業參考材料存在顯著差異。這一現象被歸因于不同材料中分支和交聯程度的不一致。
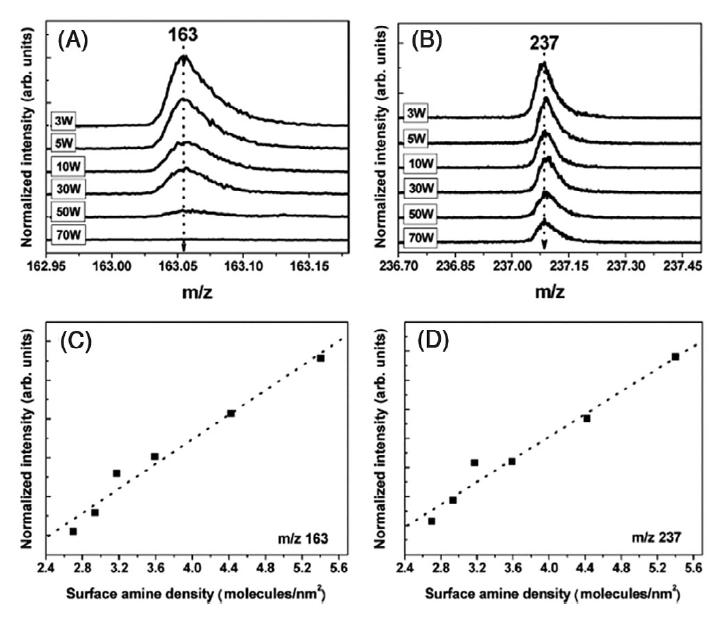
光譜分析能夠有效檢測聚合物膜表面的官能團,并通過校準曲線精確量化其覆蓋度。Hadjesfandiari等人利用光譜分析為血小板儲存袋的抗菌涂層設計提供了重要依據。具體而言,他們成功檢測到低濃度的抗菌肽(AMPs),該肽與聚合物涂層形成共價結合,且進一步驗證了AMP在整個表面上的均勻分布。Kim等人通過光譜分析法量化了等離子體聚合乙二胺薄膜表面的胺密度,該方法可通過調節等離子體功率進行優化。他們的方法采用了一條校準曲線,將二次離子信號與通過紅外(IR)和紫外-可見(UV-vis)吸收光譜確定的胺密度相關聯。由于胺不吸收紫外-可見光且在IR中提供的信號較弱,因此這些基團與化學標簽(苯甲醛)反應,為每種技術提供強烈信號。此外,在TOF-SIMS測量中也檢測到了相同化學標簽的碎片。作者識別出兩種與表面胺密度呈正比的二次離子信號,如上圖所示。該研究表明,ToF-SIMS可以有效結合表面衍生化技術,以進行表面功能性的定量分析。然而,需要采用諸如UV-vis、IR或XPS等獨立方法來校準信號。





